Verwendung von Blind Vias zur Vermeidung von Ausfällen

Richtlinien für die Verwendung von Blind Vias.
Konstruktionsparameter für Blind Vias
Blind Vias sind Durchkontaktierungen, die eine Außenlage einer Leiterplatte mit einer Innenlage verbinden ohne durch die Leiterplatte durchzustoßen.
Die Bohrung ist in der Z-Achse tiefengebohrt; es muss ein entsprechender Bohrdurchmesser gewählt werden, der eine optimale Metallisierung der gesamten Bohrwände ermöglicht.
Fünf Parameter helfen Ihnen bei der Auswahl des geeigneten Formates für Ihre Blind Vias und gewährleisten so Qualität und Zuverlässigkeit für eine lange Zeit.
/5/ Parameter für die Nutzung von Blind Vias
Um Ausfälle zu vermeiden und Zuverlässigkeit zu gewährleisten, sollte das PCB-Design folgendes berücksichtigen:
1. Bohrdurchmesser.
2. Die Größe des Restringes, der Blind-Vias.
3. Die Dicke des dielektrischen Materials zwischen den durch die Blind Vias verbundenen Lagen zzgl. der Kupferschicht.
4. Das Aspect-Ratio der Bohrung.
5. Der Lagenabstand zu der darunter liegenden Lage, die nicht mehr mit dem Blind-Via verbunden ist (bei mechanischen Bohrungen).
1 – Lochdurchmesser
Blind Vias können mechanisch oder per Laser gebohrt werden:
– Mechanische Bohrungen werden über ein Werkzeug mit einem Mindestdurchmesser von 0.15mm (zzgl. einer Negativtoleranz von -50µm) realisiert. Auf diese Weise wird nach der Durchkontaktierung* ein Lochdurchmesser von 0.05mm (oder geringfügig größer) erreicht.
– Lasergebohrte Löcher haben einen Durchmesser von 0.1mm (ohne Negativtoleranz). Auf diese Weise wird nach der Durchkontaktierung ein Lochdurchmesser von 0.05mm (oder geringfügig kleiner) erreicht.
Info: Metallisierungshülse einer Blind Via mit einer Dicke von >12µm gemäß IPC-Vorgaben
2- Größe der Restringe bei Blind-Vias
Das Blind-Via-Pad sollte einen Durchmesser von mindestens 300 µm größer als die Bohrung haben, ausgehend von einer Kupferdicke von 35µm, um den IPC-Standards zu entsprechen und ein optimales Ergebnis zu gewährleisten.
Dieser Aspekt ist grundlegend für die Zentrierung der Bohrung innerhalb des Pads. Bei Laserbohrungen kann dieser Wert auf 150µm reduziert werden.
3- Lagenabstand der beiden Schichten, die über BlindVias verbunden sind.
Die Dicken der Lagenabstände und Signallagen ist abhängig von den elektrischen Designanforderungen. Dies gilt auch für die Lagen mit Blind Vias. (Siehe auch: Aspect Ratio).
4- Aspect Ratio (AR)
Das Aspect Ratio definiert das Verhältnis zwischen Bohrtiefe und Durchmesser (Punkt1).
Anmerkung:
Die Lochtiefe ergibt sich aus der dielektrischen Dicke zweier verbundener Schichten zzgl. der Kupferschichtdicke. Diese versteht sich nach Durchkontaktierung.
Dieses ist grundlegend für die weitere Bearbeitung im Bezug auf chemische, physische und flüssigkeitsdynamische Limits während des Durchkontaktierungsprozesses. Während des galvanischen Beschichtungsprozesses müssen verschiedene Flüssigkeiten den gesamten Innenbereich des einseitig verschlossenen Zylinders der Blind-Vias optimal erreichen. Dieser Prozess wird durchgeführt, um eine dauerhafte Metallbeschichtung der Lochwand und eine zuverlässige elektrische Verbindung zu erhalten.
Dieses Verhältnis darf unter Berücksichtigung des Lochdurchmessers am Ende des Prozesses (d.h. nach der Metallisierung) maximal 1,4: 1 betragen.
5- Isolationsabstand unterhalb des Blind-Via
Diese Angabe bezieht sich auf den dielektrische Abstand zwischen der inneren Schicht, die über das Blind-Via angebunden ist und der darunterliegenden inneren Schicht, welche nicht verbunden ist. Gemäß der Toleranzen, die für den Z-Achsen-gesteuerten Bohrprozess erforderlich sind und der Form des Bohrwerkzeugs muss diese Dicke am Ende des Prozesses eine ausreichende elektrische Isolierung gewährleisten.
Beispiel für ein zuverlässiges Blind-Via
Unter Annahme einer Kupferauflage von 35µm und 100µm dielektrischem Abstand zwischen TOP-Lage und Innenlage 1, sowie min. 150µm Abstand zwischen Innenlage 1 und Innenlage 2 [E]:
In diesem Fall können Blind-Vias mit einem Durchmesser von 150µm Enddurchmesser [C] (mechanisch gebohrt) mit einem Pad von 450µm [A] konstruiert werden. Diese Bohrung wird mit einem 250µm-Bohrwerkzeug [B] realisiert. Gebohrt wird durch eine Tiefe (FR4 + Kupfer) von ca. 170µm [D]. Auf diese Weise beträgt das Aspect Ratio 1,13:1 [D/C]. Durch Einhalten des o.g. max. Aspect Ratio von <1,4:1 kann eine stabile Ausführung der Blind-Vias produziert werden.
Mindestwerte:
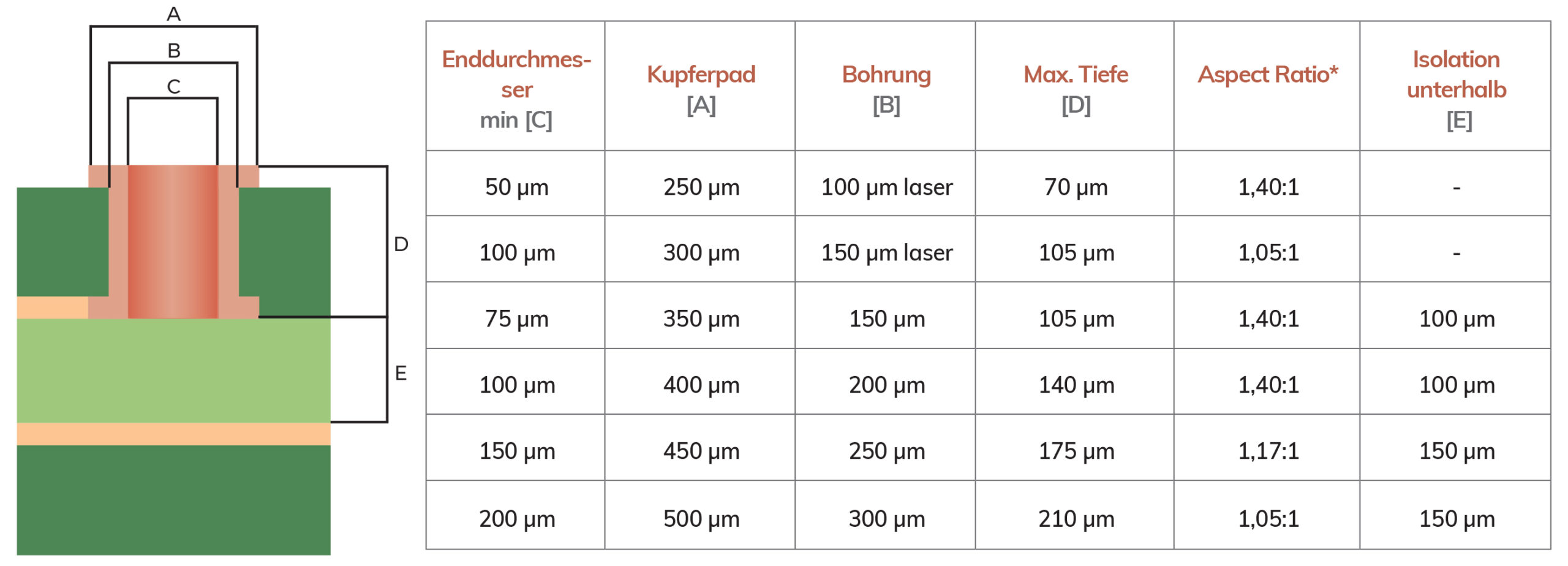
Andere Beiträge

10 Gründe, warum die Alba PCB Group Ihre Anforderungen erfüllt
Die Alba PCB Group ist eine internationale Gruppe mit Hauptsitz in Italien, die sich aus...
LESE ALLES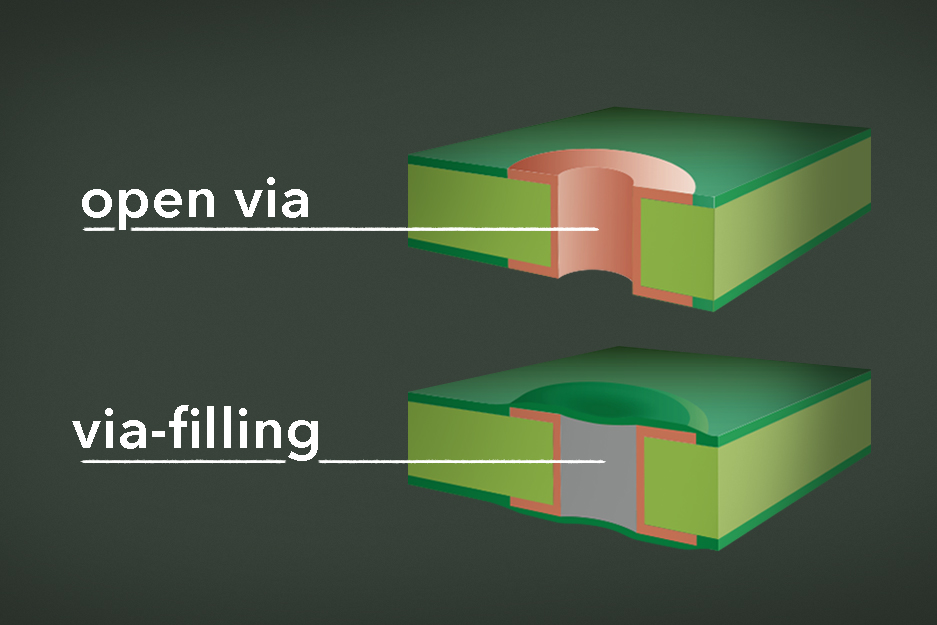
Leiterplatten: wählen Sie den Viatyp entsprechend Ihrer Anforderungen
Mit Via-Filling meinen wir den Füllprozess von Durchkontaktierungen unter Verwendung von dielektrischen/isolierenden (aber nicht nur)...
LESE ALLES
Qualitätssicherung mit 2000-facher Vergrößerung!
Unser Fokus liegt auf der Qualität! Unser Prüflabor ist der Ort, an dem wir die...
LESE ALLES